随着手机越来越高级, 内部的集成程度也越来越高,而且现在的手机中几乎都采用了球栅阵列封装模块,也就是我们通常所说的BGA。这种模块是以贴片形式焊接在主板上的。BGA模块利用封装的整个底部来与电路板连接。不是通过管脚焊接,而是利用激光焊锡球来焊接。而BGA芯片激光锡球焊过程是如何植锡?
(1)清洗
首先在IC的锡脚那面加上适量的助焊膏,用电烙铁将IC上的残留焊锡去除,然后用天那水清洗干净。
(2)固定
我们可以使用维修平台的凹槽来定位BGA芯片,也可以简单地采用双面胶将芯片粘在桌子上来固定。
(3)上锡
选择稍干的锡浆,用平口刀挑适量锡浆到植锡板上,用力往下刮,边刮边压,使锡浆薄薄地、均匀地填充于植锡板的小孔中,上锡过程中要注意压紧植锡板,不要让植锡板和芯片之间出现空隙,以免影响上锡效果。如图所示。
(4)吹焊植锡
将植锡板固定到IC上面,把锡浆刮印到IC上面之后,将热风枪风量调大、温度调至350℃左右,摇晃风嘴 对着植锡板缓缓均匀加热,使锡浆慢慢熔化。当看见植锡板的个别小孔中已有锡球生成时,说明温度已经到位,这时应当抬高热风枪的风嘴,避免温度继续上升。过高的温度会使锡浆剧烈沸腾,造成植锡失败,严重的还会使IC过热损坏。锡球冷却后,再将植锡板与IC分离。这种方法的优点是一次植锡后,若有缺脚、锡球过大或过小现象,可进行二次处理,特别适合新手使用。
(5)调整
如果我们吹焊完毕后,发现有些锡球大小不均匀,甚至有个别引脚没植上锡,可先用裁纸刀沿着植锡板的表面将过大锡球的露出部分削平,再用刮刃将锡球过小和缺脚的小孔中上满锡浆,然后用热风枪再吹一次。
责任编辑:gt
-
芯片
+关注
关注
440文章
44216浏览量
403762 -
激光
+关注
关注
19文章
2448浏览量
63048 -
BGA
+关注
关注
4文章
437浏览量
45568
发布评论请先 登录
相关推荐
专注多年BGA植球,返修,焊接,
PBGA焊接过程中锡球熔化之后球径变小
请问BGA芯片用大瑞锡球植锡为什么总失败呢?
BGA锡球焊点检测(BGA Solder Ball)
如何有效率的植回锡球,且不影响后续可靠度验证精准度?
锡浆(锡膏)干了怎么办?用什么稀释?
bga植球方法
激光锡球喷射焊接的原理和优点
激光锡球焊接工艺及应用行业
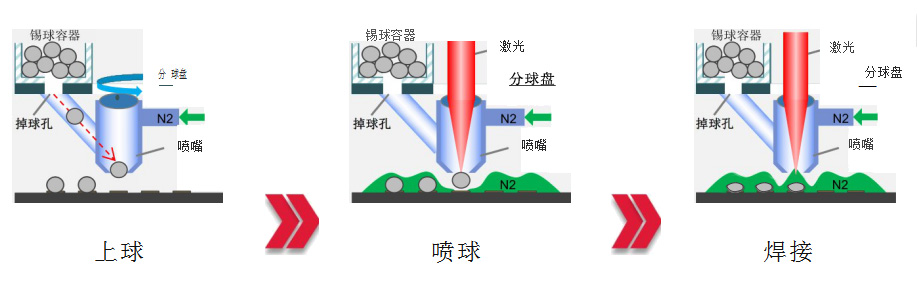
BGA锡球裂开的改善对策
汉思新材料:平板电脑主板芯片BGA锡球底部填充加固用胶方案
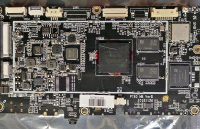



 如何利用BGA芯片激光锡球进行植锡
如何利用BGA芯片激光锡球进行植锡
















评论