一、案例背景
球栅阵列封装(英语:BGA、Ball Grid Array,以下简称BGA)威廉希尔官方网站 为应用在集成电路上的一种表面黏着封装威廉希尔官方网站 ,此威廉希尔官方网站 常用来永久固定如微处理器之类的的装置。
BGA焊接失效问题往往直接关系到器件的质量。基于此,下文针对BGA焊接出现开裂问题作出了分析。
二、分析过程
1.外观分析
说明:一焊点(左)整体开裂(如放大图所示),另一焊点无异常(右),且二者都呈现向内扭偏的状态。
2.SEM分析
说明:由于芯片PAD与PCB 焊盘未中心对齐,整体焊球向内扭偏。
失效NG焊点
针对失效焊点的断面SEM分析,开裂焊点局部图示如下:
说明:开裂焊点特征是从IMC层开裂,开裂面有契合齿纹,断面平整。Ni层状态良好,无腐蚀异常。
良好OK焊点
针对良好焊点的断面SEM分析,焊点局部图示如下:
说明:未开裂焊点特征是IMC厚度主要在1μm左右,呈现晶枝状特征,符合客户提供标准要求。
3.成分分析
图谱1:IMC
图谱2:Ni层
说明:对焊点IMC层的成分分析表明其成分主要为Ni、Cu、Sn,含量比正常。Ni层P含量6.28%,在正常范围内。
三、分析结果
从上述检测分析结果判断, BGA有形成IMC层,焊点断口平齐,在1.65μm左右,且有契合齿特征,因此可推断焊点应是在成型后,受到外部应力的作用,导致IMC整体脆断。同时应力点集中于FPC焊盘侧,表明应力可能是由FPC侧传导而来。
注:由于送样切片样品(仅两个焊点)只能显示一个剖面的状态,焊点受到何种应力作用需要从原始外观或者整体断面上分析断裂痕迹。
新阳检测中心有话说:
本篇文章介绍了BGA焊接开裂失效的分析案例。如需转载本篇文章,后台私信获取授权即可。若未经授权转载,我们将依法维护法定权利。原创不易,感谢支持!
新阳检测中心将继续分享关于PCB/PCBA、汽车电子及相关电子元器件失效分析、可靠性评价、真伪鉴别等方面的专业知识,点击关注获取更多知识分享与资讯信息。
最后,如您有相关检测需求,欢迎咨询。
审核编辑:汤梓红
-
封装
+关注
关注
124文章
7365浏览量
141278 -
焊接
+关注
关注
38文章
2793浏览量
58463 -
BGA
+关注
关注
4文章
508浏览量
46116
发布评论请先 登录
相关推荐
请问含有BGA封装的板子怎么焊接?
LTM4643 BGA的焊接问题求解
BGA焊点失效分析——冷焊与葡萄球效应
浅谈失效分析—失效分析流程

LGA封装芯片焊接失效
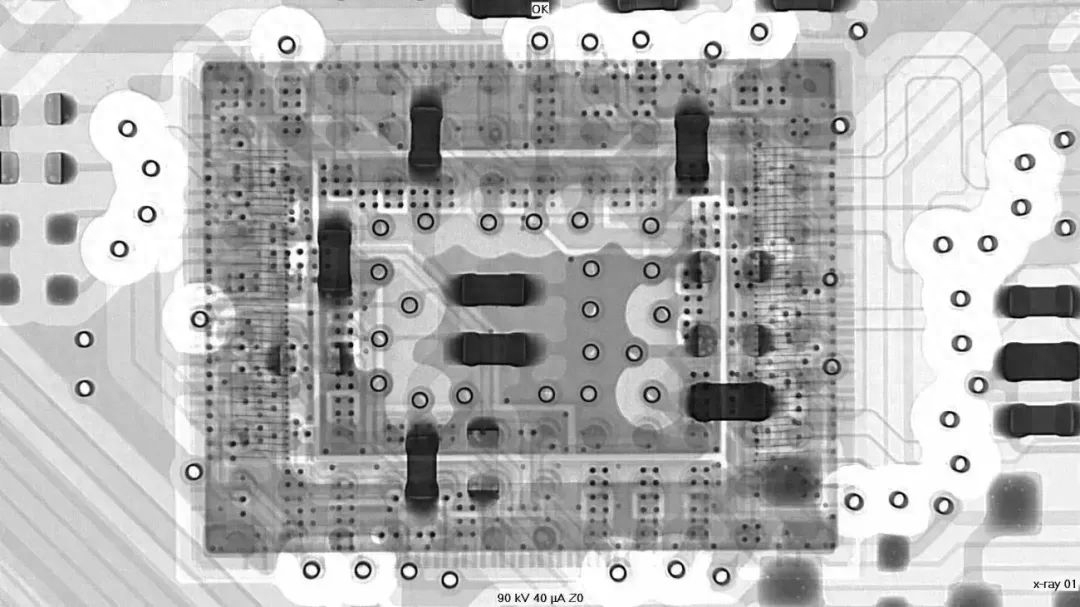
使用BGA返修台开展BGA焊接时应注意这几点
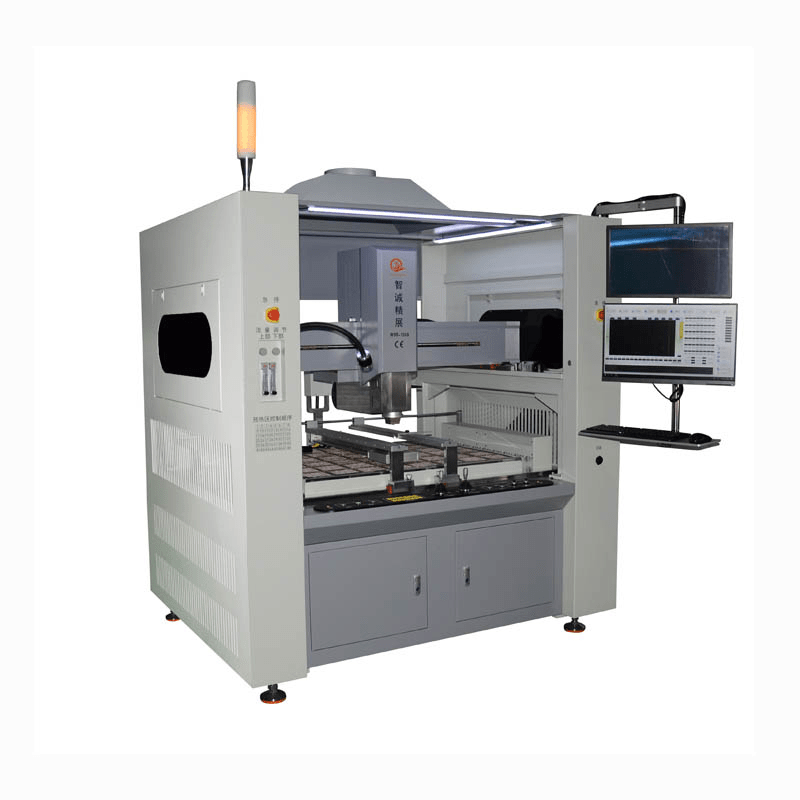
BGA焊接台在智能家居行业的关键作用是什么?





 BGA焊接开裂失效分析案例
BGA焊接开裂失效分析案例
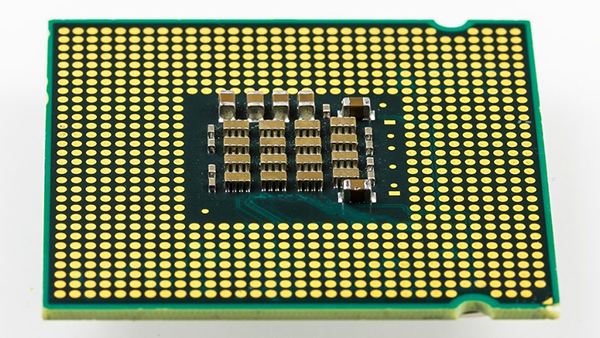















评论